康派斯是原子级高分辨率成像的专家。我们提供无与伦比的分析专业知识,为从消费电子到纳米技术的各个行业生成极其详细的表面和近表面图像。我们使用最先进的设备和创新技术,进行专家成像,以帮助进行故障分析、尺寸分析、工艺表征、颗粒识别等。如果您想研究具有埃级分辨率的材料,您可以依靠康派斯快速准确地完成工作。成像技术通常被归类为使用高级显微镜进行分析。以下是康派斯实验室提供的一些成像技术的介绍。
先进的显微镜技术,如SEM(扫描电子显微镜)、TEM(透射电子显微镜)和双光束SEM是研究样品微观结构、形态、粒径、颗粒涂层和缺陷的基本技术。
这些技术通常采用元素映射功能,例如EELS(电子能量损失光谱)和EDS(能量色散X射线光谱),它们提供有关元素组成和位置/分布的宝贵信息。
康派斯提供广泛而庞大的不同显微镜工具和服务安装基础,以匹配您的应用,从工艺开发到故障分析。除了提供高分辨率成像外,我们的分析能力使我们成为独特的合作伙伴,可以在研究、开发和故障分析过程中为您提供帮助。
为什么康派斯提供高级显微镜服务?
康派斯实验室提供您所需的专业支持和服务,以加快上市时间,填补设备和专业知识空白,并管理与产品开发相关的风险。
- 各种材料的样品制备和分析
- 采用先进产品技术的故障分析专业知识
- 广泛的仪器和专家团队,可处理复杂的项目
- 通过值得信赖的准确分析和数据快速周转
我们拥有广泛而庞大的不同显微镜工具和服务安装基础,以匹配您的应用,从工艺开发到故障分析。除了提供高分辨率成像外,我们的分析能力使我们成为独特的合作伙伴,可以在研究、开发和故障分析过程中为您提供帮助。我们可以进行亚纳米空间分辨率的结构和横截面分析、元素材料分析和微量分析。
显微镜技术包括:
- 场发射扫描电子显微镜
- 透射电子显微镜
- 扫描透射电子显微镜 (STEM)
- 像差校正-干
- 双光束 (FIB/SEM) 成像
- SEM – 能量色散光谱 (EDS)
- TEM – 能量色散光谱 (EDS)
- TEM – 电子能量损失光谱 (EELS)
透射电子显微镜
透射电子显微镜(TEM)和扫描透射电子显微镜(STEM)是密切相关的技术,它们使用电子束对样品的内部结构进行成像。高能电子入射在超薄样品上,图像分辨率约为2Å。与SEM相比,TEM和STEM具有更好的空间分辨率,并且能够进行额外的分析测量,但需要更多的样品制备。
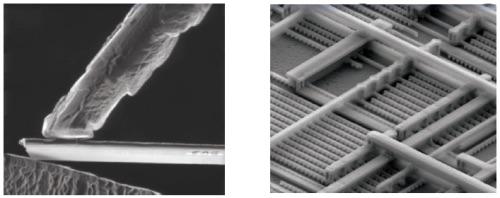 虽然比许多其他常见的分析工具更耗时,但TEM和STEM分析提供的丰富信息令人印象深刻。不仅可以获得出色的图像分辨率,还可以表征晶体相、晶体取向(通过衍射实验)、生成元素图(使用 EDS 或 EELS),并获得突出显示元素对比度的图像(暗场 STEM 模式)。这些都可以从可以精确定位的nm大小区域完成。STEM 和 TEM 是薄膜和 IC 样品的终极失效分析工具。
虽然比许多其他常见的分析工具更耗时,但TEM和STEM分析提供的丰富信息令人印象深刻。不仅可以获得出色的图像分辨率,还可以表征晶体相、晶体取向(通过衍射实验)、生成元素图(使用 EDS 或 EELS),并获得突出显示元素对比度的图像(暗场 STEM 模式)。这些都可以从可以精确定位的nm大小区域完成。STEM 和 TEM 是薄膜和 IC 样品的终极失效分析工具。
康派斯还具有像差校正STEM仪器,可从商业独立显微镜服务中提供最佳图像分辨率。
扫描电子显微镜 (SEM)
扫描电子显微镜(SEM)提供样品表面和近表面的高分辨率和大景深图像。SEM是使用最广泛的分析工具之一,因为它可以快速提供极其详细的图像。与能量色散X射线光谱(EDS)探测器相结合,SEM还可以对几乎整个元素周期表进行元素鉴定。
SEM用于光学显微镜无法提供足够的图像分辨率或足够高的放大倍率的情况。应用包括故障分析、尺寸分析、工艺表征、逆向工程和颗粒识别。我们技术娴熟的员工使您能够实现预期的结果。人对人服务确保结果及其影响的良好沟通。客户经常在分析过程中在场,从而可以立即共享数据、成像和信息。
双光束FIB(DBFIB)
聚焦离子束(FIB)仪器使用精细聚焦的离子束来修改和成像感兴趣的样品。FIB主要用于创建非常精确的样品横截面,以便通过SEM,STEM或TEM进行后续成像或进行电路修改。此外,FIB成像可用于直接对样品进行成像,检测从离子或电子束发射的电子。FIB的对比机制与SEM或S / TEM不同,因此在某些情况下可以获得独特的结构信息。双光束FIB / SEM将这两种技术集成到一个工具中,便于“切割和观察”研究。
样品制备
作为样品制备工具,FIB可以准确地产生样品的横截面,否则无法创建:
- FIB彻底改变了TEM样品的样品制备,使识别亚微米特征和精确制备横截面成为可能。
- FIB制备的切片广泛用于SEM显微镜,其中FIB制备,SEM成像和元素分析可以在同一种多技术工具上进行。
- FIB制备的切片也用于俄歇电子能谱,以快速准确地提供地下特征的元素鉴定。
- 它是检测具有小而难以接近特征的产品的理想工具,例如半导体工业中的特征以及亚表面颗粒鉴定。
- 对于难以横截面的产品来说,这是一个不错的选择,例如难以抛光的软聚合物。
康派斯使用各种材料,并定期协助公司进行FIB样品制备和分析。没有其他实验室可以与康派斯的技能,经验和仪器机群相媲美。此外,您可以依靠快速的周转时间、准确的数据和个人对个人的服务,确保您了解收到的信息。
高级显微镜示例
显微镜技术可用于表征多种类型的缺陷。其中包括:
- 金属迁移:FIB横截面和STEM/EDS调查
- 空隙:FIB横截面和SEM调查
- 颗粒:表面成像或FIB横截面,用于研究层堆叠中的尺寸,化学成分和位置
- 裂纹和分层:小面积FIB横截面或大面积氩离子铣削横截面决定了分层界面的位置和位置。如果需要,可以通过TEM微量分析确定界面化学成分。
- 厚度和均匀性:FIB横截面和SEM研究
使用先进的显微镜技术测试的材料类型:
- 纳米粒子
- 合金和金属
- 薄膜
- 玻璃、硅或碳基基材上的涂层
- 陶瓷
- 复合材料
- 集成电路器件
- 铝阳极氧化
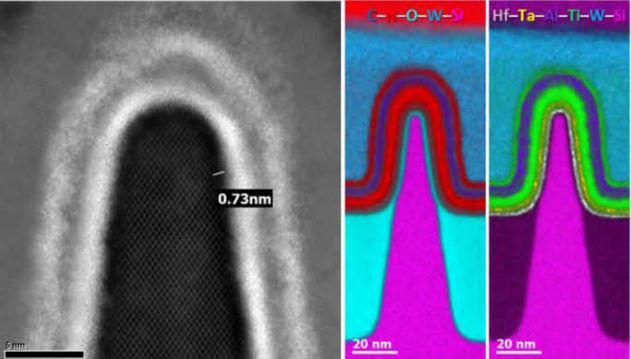
先进显微镜的工业应用
新技术迅速涌现,催生了面部识别、自动驾驶、虚拟现实和5G通信等新产业。这些增长领域通常包括FinFET、VCSEL和III/V化合物半导体。对于我们的高级显微镜团队来说,这些材料表示异质外延、立方和六边形晶格,其中器件故障通常具有复杂的 3D 结构。
FIB技术的最新发展使3D逻辑和存储设备的高精度TEM样品制备成为可能。本例显示了从 22 nm 代 3D FinFET 器件切割的栅极的 HAADF 图像,其中 L门~30 nm,如康派斯实验室高级显微镜团队最近的一篇论文所示,该论文发表在显微镜和微量分析25(S2):690-691(2019)“电子显微镜的工业应用:共享实验室视角”
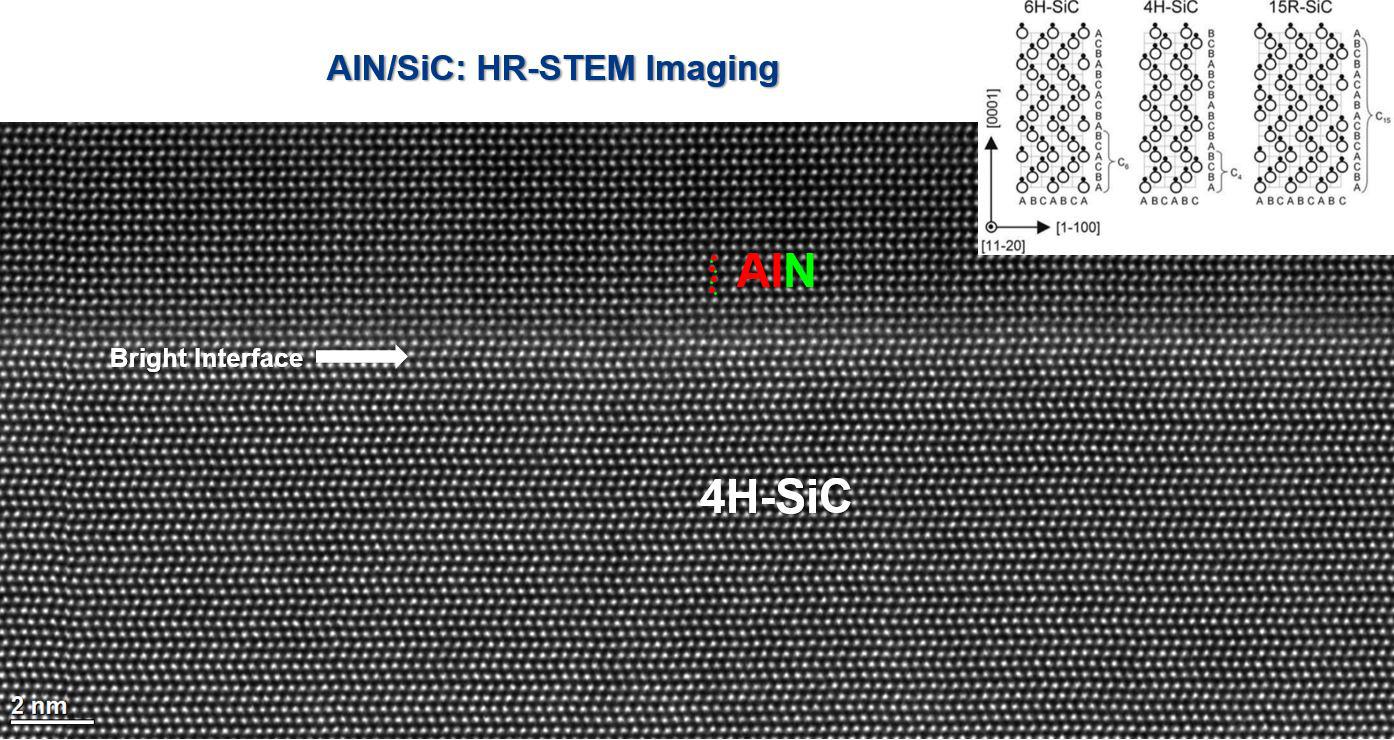 另一个有趣的例子是上图,显示了使用HR-STEM成像观察到的氮化铝/碳化硅界面。
另一个有趣的例子是上图,显示了使用HR-STEM成像观察到的氮化铝/碳化硅界面。  在上面的例子中,我们观察到GaN位错类型:使用大角会聚束电子衍射(LACBED)进行汉堡矢量分析
在上面的例子中,我们观察到GaN位错类型:使用大角会聚束电子衍射(LACBED)进行汉堡矢量分析
您也可以致电400-9621-929与我们联系或填写下方表格,让专家工程师和您讨论具体的需求。











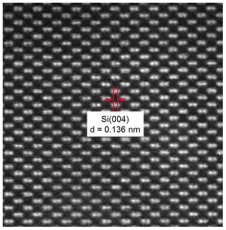



 请专家与您联系
请专家与您联系 微信号:15529346814
微信号:15529346814