1、网站使用
本网站为西安康派斯质量检测有限公司(以下简称“康派斯检测”)拥有、管理和维护。使用本网站前请您仔细阅读以下条款,使用本网站则表明您已知悉并接受这些条款,如果不接受这些条款请停止使用本网站。对于违反这些规则的行为,康派斯检测有权采取法律和公平的补救措施。
2、著作权声明
本网站所载的所有材料或内容受版权法的保护,所有版权由康派斯检测拥有,但注明引用其他方的内容除外。未经康派斯检测或其他方面许可,任何人不得将本网站上的任何内容以任何方式进行复制、公开展示、公布或分发这些材料或者以其他方式将其用于任何公开或商业目的,但对于非商业目的的、个人使用的下载或打印(条件是不得修改,且须保留该材料中的版权说明或其他所有权的说明)除外。
3、信息发布
康派斯检测网站上发布的材料和信息,包括但不仅仅局限于文本、图片、建议、链接等,虽然康派斯检测尽最大的审核,但康派斯检测并不保证这些材料和内容的准确性、可靠性、及时性、的保证,并且明确声明不对这些材料和内容的错误或遗漏承担责任,也不对其容作出任何明示或默示的、包括但不限于有关所有权担保、没有侵犯 第三方权利、质量和没有计算机病毒的保证。 康派斯检测可以在没有任何通知或提示的情况下随时对本网站上的内容进行修改,为了得到最新版本的信息,请定时访问本网站,但也不承诺及时地对这些内容进行更新。
4、商标
康派斯检测网站及相关链接网站上使用和显示的商标、服务商标和标识(以下统称“商标”)是康派斯检测和其他权利人注册和未注册的有关商标。您使用或接触该等网站上的任何内容,不能被解释为授予您任何使用有关商标的权利。未经事先书面许可,您不得以任何方式使用康派斯检测的商标。
5、个人信息保护
我们尊重广大用户的隐私,未经用户的同意,我们不搜集用户的资料。对于因以自愿填写的方式提供注册或订阅电子信息所需的姓名、性别、证件种类及证件号、电子邮件信息、电话、联系地址和邮政编码、所希望提供的服务或喜好信息、客户代码以及其他类似的个人信息,则表示您已经了解并接受您个人信息的用途,同意康派斯检测为实现该特定目的使用您的个人信息。康派斯检测承诺在任何时候、任何情况下都不会出售您的个人信息,康派斯检测只会在法律允许的范围内使用根据本条款获得的信息。但康派斯检测可能会根据法律、政府部门的要求提供您的个人信息;或在康派斯检测有理由认为有必要这样做来保护康派斯检测、客户或公众时,也尽可能在适当的范围内公开某些个人信息,在您提供个人信息的时候应该已经预见并同意这种情况的发生。
6、第三方网站
本站到第三方网站的链接仅作为一种方便服务提供给您。如果使用这些链接,您将离开本站。康派斯检测对这些网站及其内容不进行控制,也不负任何责任。如果您决定访问任何与本站链接的第三方网站,其可能带来的结果和风险全部由您自己承担。
7、国际用户
由于互联网的国际性或无国界性,因此通过本网站所提供信息的亦具有国际性,所以不是所有的在本网站上所提到的产品或服务在您的国家或地区都提供。康派斯检测不保证该网站上的资料适用于或可用于中国之外的其它地点,以及您能够从资料内容被视为非法的区域取阅这些资料。您不得违背中国出口法规使用网站或出口资料。如果您从中国之外的地点访问该网站,则您有责任遵守所有当地法律。这些使用条款和条件受中国法律管辖,且和其法律条文不相抵触。
8、更改
康派斯检测可能随时修改这些条款,您应经常访问本页面以了解当前的条款,这些条款的某些条文也可能被本站中某些页面上明确指定的法律通告或条款所取代。康派斯检测可随时终止、更改、暂停或中止该网站的任何方面,包括该网站任何特性的可用性。康派斯检测还可未做事先通知且不承担责任对某些特征和服务加以限制或限制您访问网站的某些部分或全部。康派斯检测还可终止上述授权、权利和许可,您应在此类终止时立即销毁所有资料。
9、法律
因本公告或使用本网站所发生的争议适用中华人民共和国法律。
10、争议
因本公告或使用本网站发生争议,应当协商解决,协商不成的,由相关人民法院诉讼解决。
11、解释权
本公告的解释权及对本网站使用的解释权归结于康派斯检测。
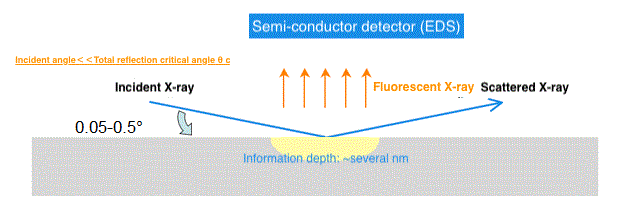 TXRF是一种高度表面敏感的技术,专门用于分析半导体晶圆(如Si,SiC,GaAs或蓝宝石)上的表面金属污染。
TXRF是一种高度表面敏感的技术,专门用于分析半导体晶圆(如Si,SiC,GaAs或蓝宝石)上的表面金属污染。